半导体制造及封装中的翘曲测量方法
本期借助南京理工大学&电子制造与封装集成湖北省重点实验室尹卓异博士的文章进行分享。
摘要:随着集成电路技术的不断发展,先进制造工艺和先进封装技术在提升芯片性能与集成度的同时,大尺寸结构、高密度互连与多芯片叠层也使翘曲等可靠性问题更加突出,增加了失效风险。为提高半导体工艺的稳定性与良率,翘曲的精确测量与分析已成为工艺控制的关键环节。本文系统综述了半导体封装中翘曲的定义、测量方法及最新研究进展。首先依据国内外标准阐明翘曲的概念及测量规范;随后介绍接触式、激光扫描、阴影莫尔、干涉、条纹投影和数字图像相关等主要测量方法,并比较其原理、优势与局限。文献统计显示,阴影莫尔法应用最为广泛,而数字图像相关方法凭借应变与热膨胀系数测量能力及良好可扩展性正快速增长;条纹投影方法的应用比例也因其高灵活性持续上升。最后,本文总结了国内外商业化翘曲测量设备在精度、视场与测量原理方面的现状,并提出国产设备的改进方向。本文旨在为翘曲测量方法的选型及半导体工艺优化提供参考,促进测量技术与产业的发展。
引言:随着信息技术的飞速发展,集成电路已然成为现代电子设备的核心组件,其性能在极大程度上决定了产品功能与用户体验。此外,高性能计算资源,例如中央处理器和图形处理器,是科技创新、经济发展及国防安全的重要基石,直接影响全球竞争中的战略地位和自主创新能力!。为满足这一需求,集成电路领域一直致力于提升芯片性能与集成度。然而,随着芯片特征尺寸的持续缩小,传统的平面工艺路线正逐渐趋近物理极限,难以维持摩尔定律的指数增长。
为突破这一瓶颈,研究焦点逐渐转向以芯粒异质集成为核心的先进封装技术。通过采用晶圆级封装(WLP)、2.5D/3D 集成等创新方案,先进封装能够在维持芯片尺寸的同时,显著提升系统的互连密度、带宽和功耗表现成为延续摩尔定律的关键力量。然而,先进封装技术也在面临新的可靠性挑战。半导体制造包括一系列复杂工艺,如电镀、磨削和退火,其工艺中的环境温度变化效应会导致热应力累积和不均匀分布并在宏观层面上引发明显的翘曲现象。此外,先进封装通常涉及高密度互连、多芯堆叠等复杂结构,内部材料的热膨胀失配是这一现象的根本原因之一。严重的翘曲不仅会破坏结构平整度,影响后续工艺,还可能引发界面分层、微裂纹等缺陷,严重威胁芯片良品率及使用寿命。有调查表明,塑料球栅格阵列封装(plasticball grid Array,PBGA)、层叠式封装(package onpackage,PoP)等典型封装产品的失效与翘曲密切相关。因此,系统地研究翘曲机理、准确表征其演化规律,对于指导先进封装工艺优化、提升产品良率和可靠性具有重要意义。
翘曲度定义及翘曲成因:在现行标准中,针对晶圆或硅片的变形定义了弓曲与翘曲两种形式,如下图所示。

根据SEMIM59 标准,弓曲被定义为在无夹持情况下,中位面中心点与基准平面之间的偏离;翘曲则被定义为在无夹持情况下,中位面相对于参照平面的最大值与最小值的差,SEMI MF534与 SEMI MF657分别规定了弓曲和翘曲的测量方法。相应地,中国标准沿用了SEMI的相关定义,并以 SEMIMF534 与 SEMIMF657 为依据,分别制定了 GB/T 6619-2009《硅片弯曲度测试方法》及 GB/T 6620-2009《硅片翘曲度非接触式测试方法》。
当样品尺寸较小时,热效应及残余应力分布较为均匀,导致变形趋势对称,即最大偏离点通常与样品中点重合。这意味着,尽管弓曲仅考虑中心点与基准面的偏离,但其仍具有较高的参考价值。此外,国际电子工业联接协会(IPC)在其测试标准IPC-TM-650中提出了与 SEMI MFS34 不同的弓曲定义方法。其采用逐点定义方式,即样品上每个点的弓曲值为该点偏离距离与样品尺寸的比值。该弓曲值为无量纲量,通常以比例形式表示。随着现代工艺和尺寸的发展,品圆及封装结构的变形复杂性增加。在实际应用中,翘曲因考虑了全场的最大偏移量,能够通过单一数值较好地反映样品全局状态,因此在后续得到了广泛应用。
进一步,由日本电子信息技术产业协会(JapanElectronics and Information Technology IndustriesAssociation, JEITA)推行的标准 ED-7306与国际电工委员会(International Electrotechnical Commission, EC)推行的标准 IEC 60191-6-19中,除了将 SEMI M59标准中的翘曲定义推广至芯片封装外,还提出了翘曲符号的对角基准线定义法,如下图所示。
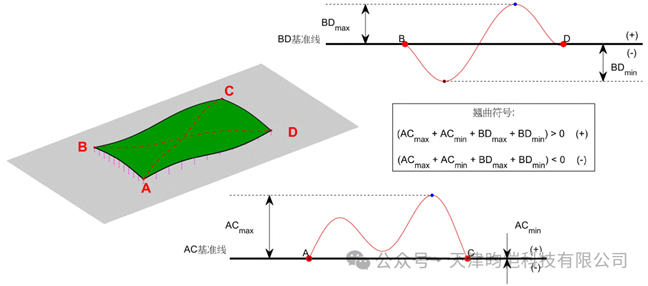
此外,在ED-7306 标准中,绝对参考面不再采用 SEMI MF534与 SEMIMF657 中的三点接触法,而是选取全场形貌的最小二乘拟合得到的虚拟平面。且其对翘曲的定义不再局限于局部三点测量,能够反映整体的翘曲状态凭借其更高的适用性,该定义在后续得到了广泛采纳,并已成为商业化翘曲测量设备普遍遵循的标准。 需要特别指出的是,在翘曲测量中,用于判定翘曲符号的基准线与用于计算翘曲值的绝对参考面实为两个不同的概念。前者仅依赖于对角线上的两个顶点及其极值数据来确立符号,而后者则以全场数据为基础,计算出绝对翘曲值。这种差异导致了ED-7306 标准中翘曲符号计算方法的局限性,具体表现在以下:
-
整体性不足:翘曲符号的判定仅依赖局部点位信息,难以全面反映样品的整体翘曲状态,可能与真实的全场分布存在偏差:
-
适用性受限:对于形状不规则的样品,尤其是非矩形样品,或在对角线上缺乏有效测量区域的情况下,翘曲符号往往无法定义;
-
鲁棒性较差:该方法仅基于四个角点与四个极值点进行计算,易受到测量噪声、局部异常或表面特征的显著影响,从而导致符号判定的不稳定性。为避免 ED-7306 标准中翘曲符号带来的困扰,JEDEC 固态技术协会在其标准JESD22-B112B中通过形态学方法将翘曲分为凸翘曲(-)、四翘曲(+)及复杂翘曲,并在最新版本 JESD22-B112C中延续此分类,如图所示。

半导体与封装结构中异质材料的变形差异,是引发结构翘曲的关键原因。其中,环境温度变化是导致结构翘曲最普遍的诱因,既会出现在半导体工艺的热过程中,也会发生在后续产品的服役阶段。这类由温度变化引发的翘曲,根源在于不同材料的热膨胀系数不匹配:当环境温度波动时,热膨胀系数较高的材料会呈现更显著的体积变化趋势,而低热膨胀系数材料的变形能力较弱,会对前者的自由伸缩形成约束,进而破坏两者的变形协调性,最终在界面处产生剧烈的应力集中,导致晶圆翘曲。固化翘曲常发生于后道工艺的注塑阶段,环氧树脂、聚酰亚胺等聚合物材料在固化阶段会因化学交联反应伴随着不同程度的体积收缩。当聚合物和基底材料的固化速率存在差异时,产生的固化应力会使得封装结构向固化较早的一侧弯曲。
除此之外,由于聚合物大多具有吸湿性,封装结构暴露于潮湿的环境中,会因固化物吸收水汽而发生膨胀。暴露于潮湿环境的封装结构,水分子通常以“自由”和“结合”两种状态存在于聚合物内。区别于“自由”状态,“结合”状态下的水分子通常会与聚合物的链结构结合,这种结合方式会大大削弱聚合物链之间的相互作用,使得聚合物材料的结构发生体积膨胀。“结合”状态下的水分子,是引发封装结构吸湿翘曲的主要原因,其引起的翘曲水平可与热致翘曲相当。因此,在相关工艺过程中,必须对结构的翘曲水平进行测量,确保翘曲水平满足后续工艺及相关标准。
翘曲测量方法:为研究翘曲状态及其演变,已经应用了多种测量方法。其中,直观的物理接触式测量方法作为检测中的一种有效手段,至今仍在使用。与此同时,随着加工工艺的提升、光学硬件的发展以及非接触式测量技术的不断进步,激光扫描、干涉测量、阴影莫尔法、条纹投影法以及数字图像相关法等方法也陆续被引入晶圆与封装结构的翘曲测量中。下文将介绍各类测量方法的基本原理、局限性及适用范围。其中,鉴于除静态测量外,热环境下动态测试的重要性不断提升,本文补充说明了各方法在热翔曲测量中的适用性。
接触测量法:接触测量方法通常需要将待测样品放置在标准平面上,通过探针法或标尺法逐点测量翘曲量,如下图所示。
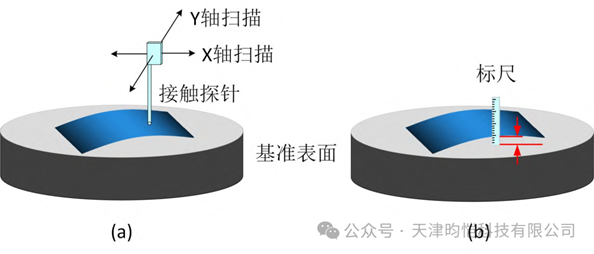
为了加快探针法的测量速度,增加路径轨道以实现自动扫描是典型方案。然而,为了确保探针在样品形貌突变处不会发生脱离或颤动等异常行为,其扫描速度难以提升。此外探针与样品接触时的反作用力大小被作为关键指标以保证接触的稳定性,但加载的力可能会引入额外的变形,影响测量精度。
对于标尺法,通常采用人工选择样品最大翘曲点的方式,借助塞尺、卡尺以及直尺等度量工具进行单点测量。然而,人工选择过程具有较大的主观性,容易引入人为误差,且该方法仅能提供单点数据,缺乏对翘曲形貌的详细描述。因此,标尺法通常仅适用于对精度要求较低的场景。尽管其精度有限,但由于操作简便、成本低廉,标尺法在低精度需求下的科研及工业领域中仍被广泛采用。
此类方法由于不依赖表面的光学特征,故可同时适用于具有镜面特性的晶圆样品以及具有哑光特性的封装结构。但探针法依赖于光栅尺等位移转换模块,且探针本身存在一定的热胀冷缩特性,因此在动态热测量过程可能存在潜在的误差。此外由于模拟回流焊等动态热过程可能达到200摄氏度以上的高温,基于人工的标尺法同样存在应用问题。
激光测量法:激光技术及其硬件的进步显著提升了激光系统的效率和可靠性。在此基础上,各类基于激光的测量方法相继被开发并不断完善。需要注意的是,尽管许多干涉测量方法也使用激光作为光源,但其基本原理与几何原理的激光测量方法存在显著差异。因此,在本文中干涉方法将在后续章节中进一步介绍。在激光测量技术中,线结构光、激光点阵及共聚焦是翘曲测量中的典型手段。
线结构光是一种通过投射激光线获取物体三维形貌的光学测量技术,其原理基于三角测量法。在工作过程中,激光通过柱面透镜扩展为一条线并投射到被测物体表面。当物体表面存在高度变化时,激光线的形状和位置会发生相应变化。通过相机捕捉激光线在物体表面形成的轮廓曲线,并计算其在图像中的位移,即可重建物体的三维形貌。线结构光的典型结构如下图(a)所示。该方法具有较高的动态测量范围,尤其适用于大面积样品的扫描和三维重建。线结构光技术可适用于多种表面类型,包括镜面和哑光样品。然而,在镜面测量中,由于激光线具有扩散角,随着光程的增加,激光线的线幅会变宽,通常需要引入哑光参考基准面以实现结构信息的二次成像。在现代工艺对精度要求不断提升的现状下,线结构光方法亚毫米级的精度往往不再能满足测试的精度需求。此外,单次测量仅能获取扫描线幅上的三维坐标,因此需要通过平移样品进行多次采样以得到全场面型。
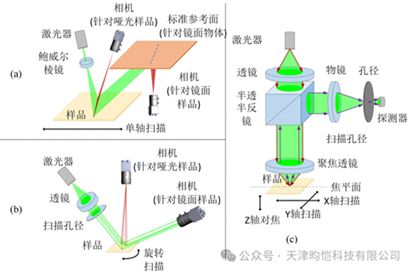
激光点阵,又称多光束光学传感器(multi-beamopticalsensor,MOS),是传统单点激光测量技术的扩展,其原理与线结构光相同,均基于三角测量法激光点阵系统的典型结构如上图(b)所示。该系统采用准直的激光孔径阵列,因此其测量视场较小,但测量精度较高。与线结构光不同,激光点阵的测点路径之间不存在扩散角,因此在测量镜面样品时通常不需要使用额外的基准面进行结构信息的二次成像。激光点阵不仅可以高精度地重建样品的三维形貌及翘曲特征,还可以在不依赖三维重建的情况下获取镜面样品的衬底曲率、薄膜厚度及通过斯托尼方程(Stoneyequation)计算薄膜应力,因此激光点阵广泛应用于晶圆测试中。但虽然测量精度较高,但由于其采样密度较低,实际测试时通常需要旋转样品进行多次扫描。
共聚焦技术是一种基于光学成像的高精度测量技术,在三维形貌测量和微观结构分析中具有显著优势。其原理是通过将光源聚焦于样品表面,利用针孔滤波器仅允许来自焦平面的光信号通过,从而抑制其他平面的散射光,最终获得高纵向分辨率的图像共聚焦系统的结构如上图(c)所示。该系统能够在纵向上实现极高的分辨率,特别适合用于微小结构的三维重建和精细表面形貌测量。传统光学显微镜由于无法有效抑制非焦平面上的光信号,通常会导致图像模糊,尤其是在深度方向上。而共聚焦系统通过针孔设计能够消除这些干扰,生成更为清晰的三维图像。然而:共聚焦技术也存在一些局限性。首先,由于系统复杂且成本较高,共聚焦技术的普及和应用受到限制。其次,共聚焦系统通常依赖逐点扫描或并行阵列扫描:这在测量大面积样品时会导致采样密度和效率偏低,尤其是在需要对大尺寸样品进行动态测量时,如何在采样速度与分辨率之间取得平衡,仍是一个技术挑战。
阴影莫尔法:莫尔法的核心在于参考栅与变形栅的叠加,从而通过频域信息分析出变形栅所对应的形貌及位移。由于物体表面制栅对样品表面有较高要求且难以控制精度,阴影莫尔法作为一种典型方法在翘曲测量中得到了更广泛的应用。其通过将高精度物理栅(参考栅)与投射在样品表面的影子(等效为变形栅)叠加,利用相机捕捉频率叠加后的条纹图案来分析出样品表面高度的变化。值得注意的是,虽然部分工作将条纹投影也称为投影莫尔(projection moiré),但由于其高度抽象化,在主流中一般不将其归类为莫尔法。阴影莫尔测量系统的典型设置包括一个准直光源、一个正对待测样品的相机以及一个贴近样品表面布置的朗奇(Ronchi)光栅,如下图所示。
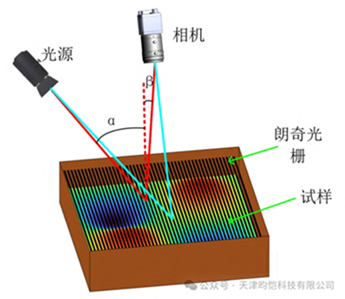
干涉法:干涉方法是一类以光的波长为标尺的高精度测量技术,常用于纳米级至亚微米级的表面形貌和变形测量。常见于翘曲测量中的干涉方法包括泰曼-格林干涉法、菲索干涉法和剪切散斑干涉法。此类方法的最终图像分析与阴影莫尔法均可归结为由条纹处理驱动的相位求解方法。由于高步相移的精度优于传统傅里叶方法,且不会因窗口效应损失空间分辨率,因此采用压电陶瓷驱动的相移方法已成为广泛的实现途径。泰曼-格林干涉法、菲索干涉法和剪切散斑干涉法的系统结构如下图所示。
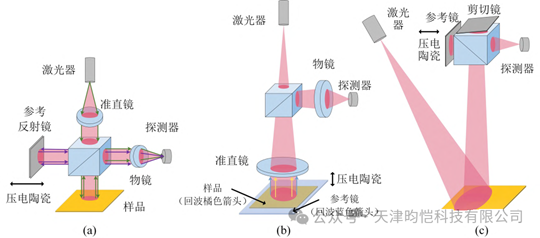
泰曼-格林干涉法的光路设计源自经典的迈克尔逊干涉仪。与迈克尔逊干涉仪相比,泰曼-格林干涉仪在光路中增加了像差矫正透镜,并移除了用于矫正光程差的补偿板,从而简化了系统结构,但仍属于分光路干涉结构。该方法的优势在于其高分辨率和精度,广泛应用于光学表面的形貌测量。然而,由于采用分光路结构,容易受到环境干扰的影响,测量过程中对环境稳定性的要求较高。
菲索干涉法则通过将参考面与待测面置于同一光路下,形成共光路干涉结构。由于参考光和探测光沿同一光路传播,菲索干涉仪相较于分光路干涉仪具有更强的抗干扰能力、更小的误差和更高的测量精度。然而,菲索干涉法与泰曼-格林干涉法,均依赖待测样品表面的镜面反射光产生干涉。即当表面粗糙度接近或超过光波长时,散射光将占主导地位,此时干涉效果将受到严重影响。对于实际工程应用中的哑光表面样品,如大多数芯片及其过程形态,难以通过抛光或喷涂等后处理将其制备为反光表面,这不仅复杂还极有可能破坏样品的原始形貌结构。
剪切散斑干涉法与菲索干涉法一样,采用共光路结构,这使其在抗干扰性方面具有优势。与前两者不同,剪切散斑干涉法允许检测粗糙或不规则的非镜面表面,且仅适用于测量加载下样品的变形梯度。其原理是通过比较变形前后两幅散斑图像的差异,获取由变形引入的相位差,从而求解出相对变形梯度。在热翘曲测量中,热载荷可作为加载量,从而得到样品的变形趋势。由于剪切散斑干涉法无法直接获取样品的形貌信息,其应用更多局限于无损探伤领域,因而在翘曲测量中受到限制。
除上述三种方法外,为了提升测量质量及普适性白光干涉以及电子散斑干涉等方法在近期得到了快速发展与应用,但其基本干涉原理仍然保持一致。总体而言,干涉方法的测量精度通常在纳米级至亚微米级,适用于高精度表面测量。然而,面对高动态范围的样品时,这些方法可能会失效。此外,尽管共光路设计能够有效减轻环境干扰的影响,但在其测量精度范围内,热辐射和热流扰动等环境因素仍可能带来显著的误差。此外,由于激光功率及透镜尺寸的限制,大尺寸样品的测量仍面临一定挑战。
条纹投影法:条纹投影法通过条纹图案的调制来获取物体表面的形貌信息,设备结构如下图所示。
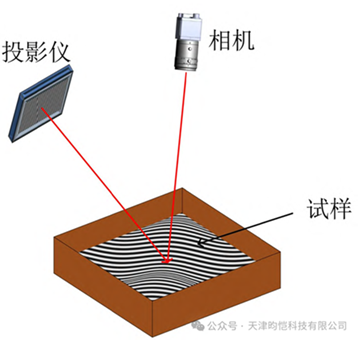
随着 DLP(digital light processing,数字光处理)等投影设备的发展,高质量、低成本且便捷的条纹图案生成促进了条纹投影法在微电子等多种测量场景下的广泛应用。与阴影莫尔法不同,条纹投影法不依赖于贴近待测物体表面的物理光栅,而是通过投影设备直接将条纹图案映射到物体表面。物体表面的高度会对条纹图案进行调制,从而将频域信息与高度信息相耦合通过相机拍摄调制后的条纹图案,并计算其相位信息即可利用相位-高度映射或三角测量原理获取物体的形貌信息。在条纹投影法中,投影仪发出测量信息经过物体表面调制后被相机接收。因此,动态测量范围主要由投影仪的投影范围和相机的景深决定,通常远大于传统的阴影莫尔法或干涉方法。这使得条纹投影法在大范围测量中具有显著优势,特别适用于测量复杂形状或大尺寸样品。
数字图像相关法:数字图像相关法是一种基于图像处理的非接触式全场光学测量技术。随着图像采集和处理设备的进步,被广泛应用于材料和结构的力学性能测试中。数字图像相关法由于能够获取热膨胀系数等参数,其在热翘曲测量等领域的应用也在迅速增加。
该方法通过对比物体在变形前后的图像,采用以逆高斯-牛顿为代表的相关性匹配算法,对物体表面各点位置进行追踪。其基本原理是在样品表面施加自然纹理或人工散斑图案,当样品发生变形时,这些图案会随之产生相应的位移和形变。通过高分辨率相机采集变形前后的图像,再利用子区域内灰度分布的变化来识别散斑图案的位移,从而能够在像素坐标系下精确计算出全场位移分布。进一步地,结合多视角成像所建立的立体匹配关系,还可以实现三维空间中表面形貌、位移以及应变信息的重建。以立体数字图像相关法为例,其设备结构如下图所示。

需要注意的是,除了相机分辨率外,数字图像相关方法的测量精度与表面制斑工艺直接相关。尤其是在扩展至热翘曲测量时,由于粘接胶层与油墨在高温下会产生热融效应,传统的水转印等便捷制斑方法难以提供稳定可靠的测量基础。同时,为满足高精度测量的需求,所需散斑颗粒的尺度往往需要进一步减小,这不仅增加了制斑工艺的复杂性,也显著提升了操作难度。
已有方法对比与总结:综上所述,前文已对各类翘曲测量方法的基本原理、测量精度及适用范围等方面进行了较为系统的论述。需要指出的是,不同方法在空间分辨率、测量效率、可适用的样品尺寸以及实验环境要求等方面各有优势与局限。因此,为了便于更加直观地对比其性能特点,并为后续方法的选择与应用提供参考,本文对上述典型方法进行了归纳与总结,见下表。

备注:以上内容源于参考文献,详情请下载原文阅读,如有误或侵权请联系作者更正或删文!
参考文献:[1]尹卓异,员方,崔翰文,等.半导体制造及封装中的翘曲测量方法与应用进展[J/OL].电子测量与仪器学报,1-22[2026-01-14].



